
Autonomous Robotics Lab
Teknologisk Institut kan hjælpe med at afklare, hvor og hvordan autonome, mobile robotter og droner kan gøre en forskel for din virksomhed.

Metallografisk laboratorie
I FORCE Technologys metallografiske laboratorie udføres karakterisering og skadesanalyse af metalliske komponenter og materialer vha. klassiske makrostruktur- og mikrostrukturundersøgelser.
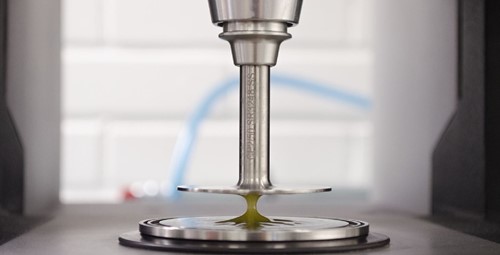
Analyse af partikler og dispergeringer
Hos Teknologisk Institut er vi eksperter indenfor partikelkarakterisering og har mere end 25 års erfaring indenfor karakteriseringsløsninger.

Elektrokemiske målinger
DFMs laboratorium for elektrokemi tilbyder faciliteter inden for målinger af elektrolytisk ledningsevne og pH af for vand og vand-opløsningsmiddel blandinger. Kalibreringsydelserne er DANAK akkrediterede i hen-hold til ISO 17025 og ISO 17034

Metrologilaboratoriet - CT scanning
Teknologisk Institut er anerkendt for at have den største tekniske kompetence inden for metrologi på en række områder og er af Sikkerhedsstyrelsen udpeget som nationalt metrologilaboratorium.

Prototypeværksted
Teknologisk Institut giver borgerne fri adgang til prototypeværkstedets maskiner, teknologier og kompetencer. Dette med en klar mission om at føre flere ideer til markedet.